半导体芯片的制造流程涵盖了IC设计、IC制造及IC封测三大核心环节。其中,光刻技术扮演着至关重要的角色,它负责将掩模版上的芯片电路图精细地转移到硅片上。这一工艺不仅被视为IC制造的枢纽,更是整个生产流程中最为繁复且决定性的步骤。
在芯片的制造过程中,通常需要历经20至30次的光刻工序,这些工序不仅耗时长久——约占整个硅片工艺时长的40~60%,更在成本上占据着举足轻重的地位,其费用甚至可高达整个硅片制造工艺的1/3。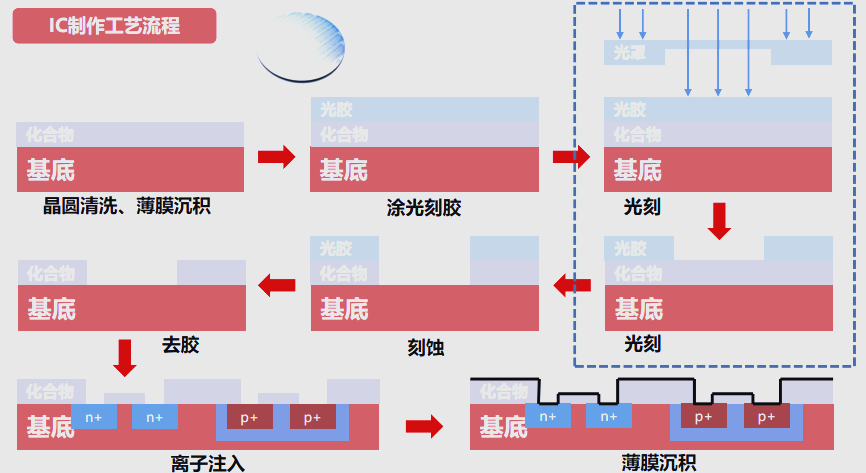
通过激光或电子束直接在光掩模板上写入设计,随后利用激光辐照光掩模板,硅片上的光敏物质在感光后发生材料性质的转变。经过显影步骤,芯片从设计版图到硅片的转移便得以完成。
光刻工艺通常包含多个工序,如硅片表面清洗烘干、涂底、旋涂胶、软烘、对准曝光、后烘、显影、硬烘、刻蚀以及检测等。其中,DUV/EUV设备作为光刻工艺的核心,汇聚了数学、光学、流体力学、高分子物理与化学、表面物理与化学等多领域的顶尖技术,被誉为半导体工业的明珠。DUV/EUV设备的性能和精度直接决定了芯片的制程和性能水平。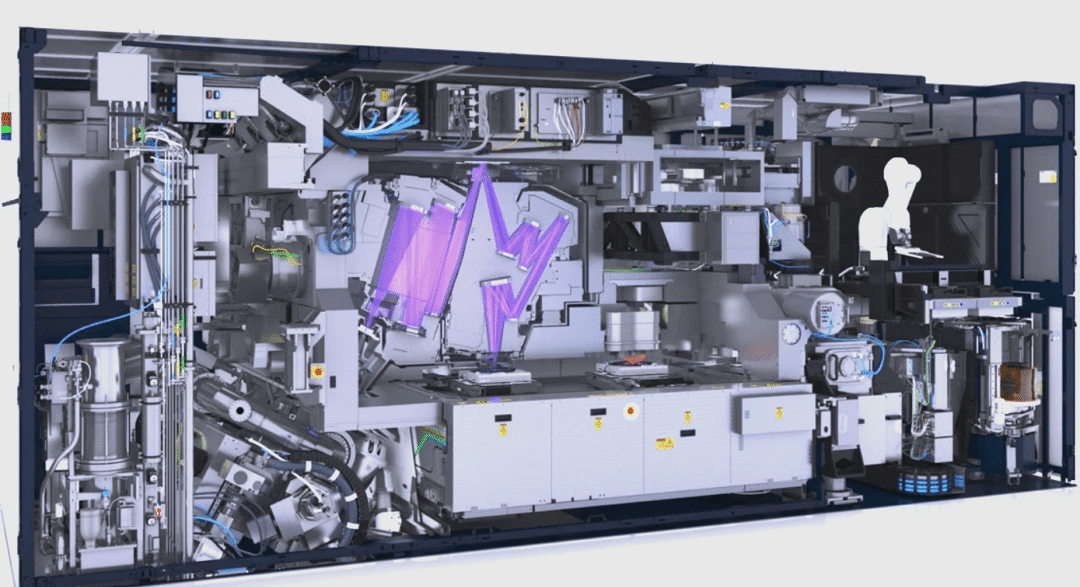

DUV/EUV技术,作为当今世界最尖端的技术之一,其技术核心仅被少数国家所掌握。目前,全球最顶尖的设备由荷兰的ASML公司制造。随着光源的改进和工艺的创新,DUV/EUV已经历了五代产品的演变。每一次光源的升级都极大地推动了其所能达到的最小工艺节点的突破。在技术节点的更新历程中,ASML公司凭借卓越的技术实力和前瞻性的战略布局,成功把握了两次重大变革的先机,从而稳固了其在行业内的领先地位。
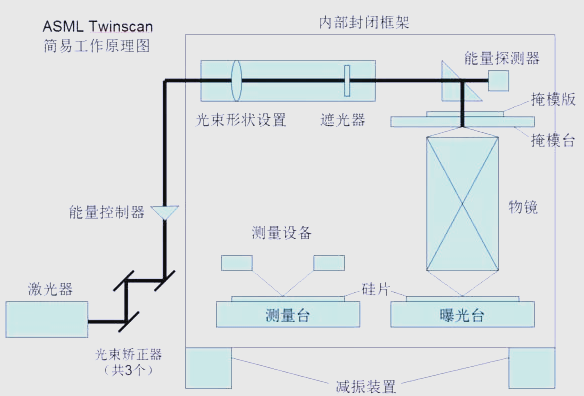
▲ ASML Twinscan简易工作原理图:在集成电路(IC)制作过程中,光束需穿过掩模及镜片,通过物镜补偿光学误差,进而将线路图精准曝光在涂有光感涂层的硅晶圆上,随后进行显影。其中,激光器作为关键光源,而物镜系统,通常由近20个直径为200~300mm的透镜精密组成,是确保曝光精度的核心设备。
TWINSCAN NXT:2000i DUV(双工作台深紫外光刻系统)是ASML的最新浸没式光刻技术成果,作为EUV技术前的重要过渡,它为后续7nm/5nm工艺节点的产能提供了有力支持。
值得一提的是,在2023年12月,ASML宣布已成功交付首台2nm EUV光刻机,标志着其在光刻技术领域的又一重大突破。据悉,每台新机器的成本高达3亿美元以上,其体积庞大,足以装满一个标准卡车车厢。
顶级的EUV(极紫外)光刻机包含多达10万个零部件,其中四大核心组件为双工件台、光学系统、控制软件以及物镜系统。与DUV(深紫外)光刻机不同,EUV必须在严格真空的环境下操作。这是由于两者的光路系统和光源存在显著差异。DUV光路主要依赖光的折射原理,而EUV则采用光的反射原理。此外,DUV使用193nm波长的紫外光作为光源,而EUV则选用波长在10-14nm范围内的极紫外光。由于极紫外光极易被介质吸收,且在空气中会迅速损耗,因此只有在真空环境中才能最大程度地保持光源能量的完整性。这种环境还能有效减少空气流动波和空气折射率对测量结果的影响。对于EUV光刻机而言,精密的反射光学器件以及整个光束路径的真空密封都是不可或缺的。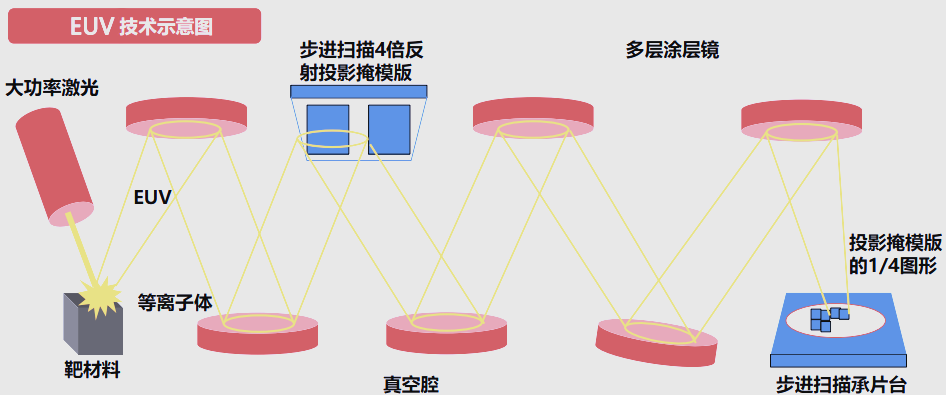
因此,EUV的生产同样需要专门的真空解决方案来支持。以全球半导体行业真空解决方案的佼佼者Edwards为例,该公司在2021年发布的“Understanding the Integrated Vacuum Challenges of HVM EUV Lithography”一文中详细阐述了其真空技术。据统计,过去11年间,Edwards已成功发布了超过120套专为EUV设计的真空系统,并已成功安装了70余套EUV集成真空系统。
▲TechInsights公布了2023年半导体设备商十大排名,Edwards与ASML等知名企业一同上榜,并位列第四。
此外,真空系统在EUV技术中还发挥着氢气回收的重要作用。在EUV的工作流程中,会使用到大量的氢气作为保护气氛,以防止锡元素发生氧化反应。同时,氢气还能有效阻止颗粒污染物在反射透镜表面上的沉积,从而确保EUV设备中的关键光学元件始终保持清洁无污染。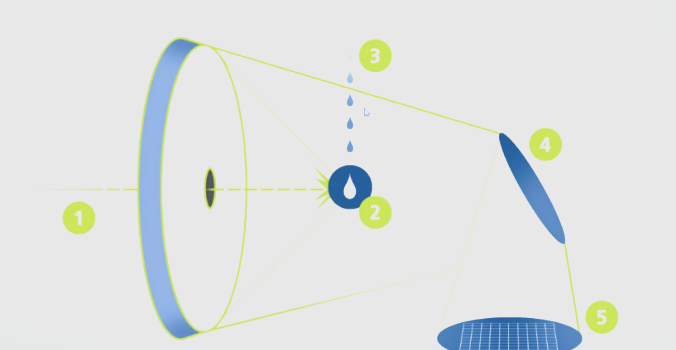
▲ EUV 工作过程示意图:首先,CO2激光脉冲被放大至高功率,输出超过30kW平均脉冲功率的激光束,其脉冲峰值功率更可高达几兆瓦。接着,不断滴落的锡珠在激光束的击打下,转变为发光的等离子体,并发出波长为13.5nm的极紫外光。随后,这些极紫外光经过聚焦,通过反射透镜传输至掩模,并最终照射到晶圆基片上。
鉴于氢气在空气中易燃,EUV真空系统不仅配备了专为EUV工艺设计的真空泵,还必需装配氢气回收系统(HRS),以有效回收并再利用大部分(至少70%)的氢气,从而降低EUV运作时的能源消耗,确保安全与环保。
除了EUV设备内部需要维持真空环境外,其光学配件的制备过程同样离不开真空技术。例如,EUV反射镜的多层反射层便需要借助高精密的真空镀膜机进行制备。图中展示的NESSY系列设备,便是专门为生产X射线或EUV光谱范围内的反射镜而设计的理想选择,其工作时的真空度需达到小于9×10-7帕的标准。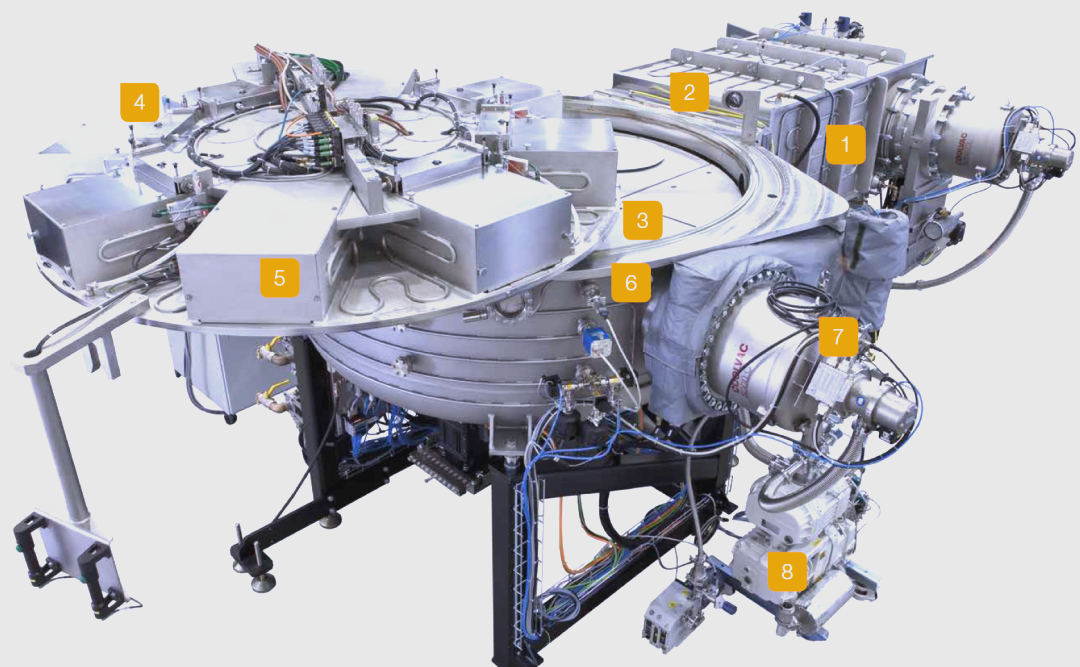
▲NESSY系统构造详解:
- Heated load lock(加热负载锁):确保在装卸过程中反射镜的稳定性。
- Handling for loading/unloading(装卸装置):简化反射镜的装载与卸载操作。
- Planetary substrate drive with sub-rotation and speed profiles(行星基板驱动):提供精确且灵活的运动控制。
- Chamber lid for ease in service(维修腔体盖板):便于设备的日常维护与检修。
- Magnetron-sputtering cathodes PK 600(磁控溅射阴极PK 600):高精密溅射技术,确保反射镜的质量与性能。
- Adjustable sputter distance(可调溅射距离):灵活适应不同尺寸与需求的反射镜制备。
- Cryo pump(低温真空泵):提供稳定的真空环境,确保反射镜制备的准确性。
- Dry pre-vacuum pump set(干式前级真空泵组):预真空处理,提高工作效率与设备寿命。
