光刻工艺的成本是如何计算的?为什么掩模版的成本不能忽视?
阿尔法经济研究2021-11-22 10:12

掩模版又称光掩模、Mask、光罩,是光刻工艺中所使用的图形母版,通过光照可将设计好的电路图形投射到光刻胶上,再通过曝光、显影等工序,将电路图形刻在晶圆上,是光刻工艺中不可或缺的原材料。
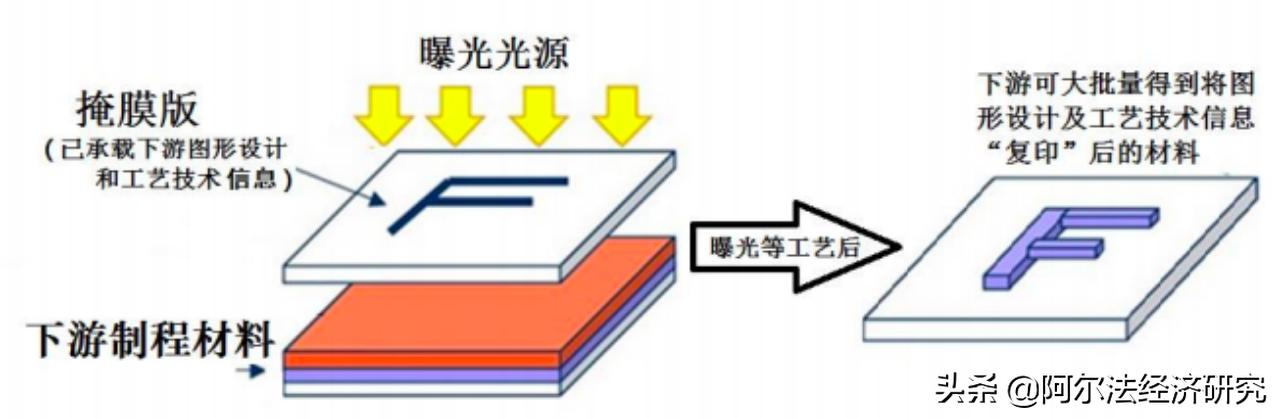
资料来源:掩模版作用,公开资料整理,阿尔法经济研究
一项新的光刻工艺能否量产,除了技术指标本身能否满足要求,更重要的是要考虑工艺成本,能否为芯片生产带来足够的经济效益,毕竟芯片造价的30%-40%来自光刻部分。
光刻工艺成本包括光刻设备、掩模版、光刻材料及与工艺相关的测量。SEMATECH提出了一个光刻工艺成本模型,这其中Ce为每年光刻机和匀胶/显影机的成本(包括折旧费、设备维护费和安装调试费);Cl是技术人员的薪酬,Cf是光刻机每年占用的净化间成本;Cc是光刻耗材的成本;Cr是光刻胶的单价;Qrw是每片晶圆消耗的光刻胶用量;Nc是一年中旋涂的晶圆数量;Ng是一年中曝光的晶圆数量;Cm是掩模版的成本;Nwm则是掩模版能曝光的晶圆数量:

资料来源:光刻工艺成本模型,公开资料整理,阿尔法经济研究
掩模版和光刻设备的造价是构成光刻工艺成本的两个主要方面。随着器件尺寸不断微缩,光刻工艺中掩模版的成本占比不断上升。
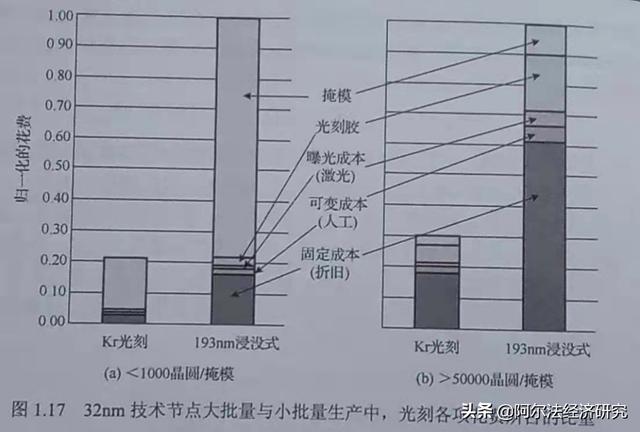
资料来源:不同节点及不同批量生产下光刻工艺成本构成,公开资料整理,阿尔法经济研究
在小批量中掩模版成本成为光刻工艺成本的最大来源,但在大批量生产中这一成本占比将大幅降低,设备折旧则成为最大的成本来源。因此在光刻工艺中,降低工艺成本的途径,除了提高光刻工艺良率,保证不返工,延长掩模版和光刻机的使用寿命将成为降低成本的重要举措。
举报/反馈
0
0
收藏
分享
